快訊
- 輝達亞太研發中心+1!聯手新加坡重押「這領域」 OpenAI也來了
- 泰國擬取消對93國60天免簽 外交部:尊重泰方決定
- 眼科診所「電梯斷頭」清潔阿姨死因出爐 「不可能會這樣!」尪崩潰
- 談判破裂!三星工會宣布明起全面罷工 台股記憶體股聞訊走強
- 替兒子曾煥嘉撇貪污!新北老議員認了聘「假員工真助理」 被質疑違法回這句
- 吸胸頭埋雙腿!色狼庭長二審重判3年10月 高檢署聲請限制出境出海慘遭打臉
- 批在野用「綠友友」刪無人機是藉口 賴清德舉光電反擊:藍縣市問題更多
- 因應龍科三期電力需求大潭要蓋10號機?曾文生:現在瓶頸在「電網」
- 深化跨境司法合作 法務部辦研討會打造全球防制犯罪堅實網絡
- 三星引發南韓罷工潮!Kakao五大工會投票通過罷工案
- 蛇蠍「李團長」一審判11年 詐騙逼死豐原五口「2套路+5大驚句」曝光
- 行政院會拍板國防特別預算 第一期近2950億、今年先編88億舉債支應
- 工商界看待520演說!林伯豐拋兩岸復航、鬆綁禁團令等五大建議
- 中油、台電財務惡化10月電價蠢動?經長龔明鑫:持續爭取預算撥補
- Gemini Spark來了!代理式AI分析帳單、寫工作日誌 5大升級亮點一次看
- 上班推銷直銷營養品 北市聯醫告兩醫護「涉詐獎勵金」 這原因不起訴
- 技鋼擴展儲存解決方案 支援 AMD EPYC 8005 伺服器處理器
- 光寶科董座宋明峰:今年為新的轉捩點 擴大研發投資強化資本結構
- 核三乾貯投標失利反控台電「罔顧核安」?經長鬆口:支持台電提告
- 談判破局原因曝光!三星電子:接受工會要求有損管理原則
台積電布局前瞻先進封裝 SoW-X系統級晶圓2027年量產!比CoWoS運算高40倍
2025-05-10 07:00 / 作者 戴嘉芬

台積電正積極擴大CoWoS、InFO、SoW先進封裝產能。圖為今年即將量產CoWoS的先進封測五廠。取自TSMC
全球企業積極布局 AI 算力,AI 運算需求每季翻倍成長,對半導體晶片效能要求不斷提升,已超越摩爾定律,尤其在2奈米以下製程節點,搭配先進封裝技術,能允許晶片放入更多電晶體,藉此提升性能,同步降低成本,因此先進封裝成兵家必爭之地。台積電不僅 CoWoS 產能持續倍增,更積極布局 SoW、SoIC 下一代先進封裝領域,將在2027至2029年量產。根據工研院產科研究所統計,2026年全球先進封裝市場比重將超過傳統封裝,呈現逐年成長,未來五年年複合成長率將達10.9%;而2.5D/3D IC堆疊技術則為先進封裝的開發核心。
另根據 IDC 研究指出,在輝達、超微、AWS、博通與雲端服務供應商等高效能運算客戶需求推動下,台積電 CoWoS 產能持續倍增,目標將從2024年的33萬片大幅擴充至今年的66萬片,年增100%,其中以 CoWoS-L 產品線年增470%為主要動能,另包括日月光和美國 Amkor 產能也陸續增加中。而台灣設備供應鏈包括濕蝕刻、點膠、揀晶等關鍵製程設備廠商,將在此波擴產潮中獲得更多成長契機。
台積電近年積極布局先進封裝領域,目前 TSMC 3DFabric 技術家族目前已有四大平台,包括 TSMC-SoIC、CoWoS、InFO、TSMC-SoW 等 2.5D/3D解決方案。其中, TSMC-SoIC 平台用於3D矽晶片堆疊,並提供 SoIC-P 和 SoIC-X 兩種堆疊方案;SoIC-X 是一種無凸塊堆疊解決方案,適用於 HPC高效能運算應用。SoIC-P 則是微凸塊堆疊解決方案,適用於講求成本效益如行動式應用的應用。
而 CoWoS、InFO、TSMC-SoW 則用於先進封裝領域。其中,InFO 平台包括 InFO-PoP 和 InFO-2.5D,前者適用於高階行動式應用,後者則適用於高效能運算的小晶片整合。
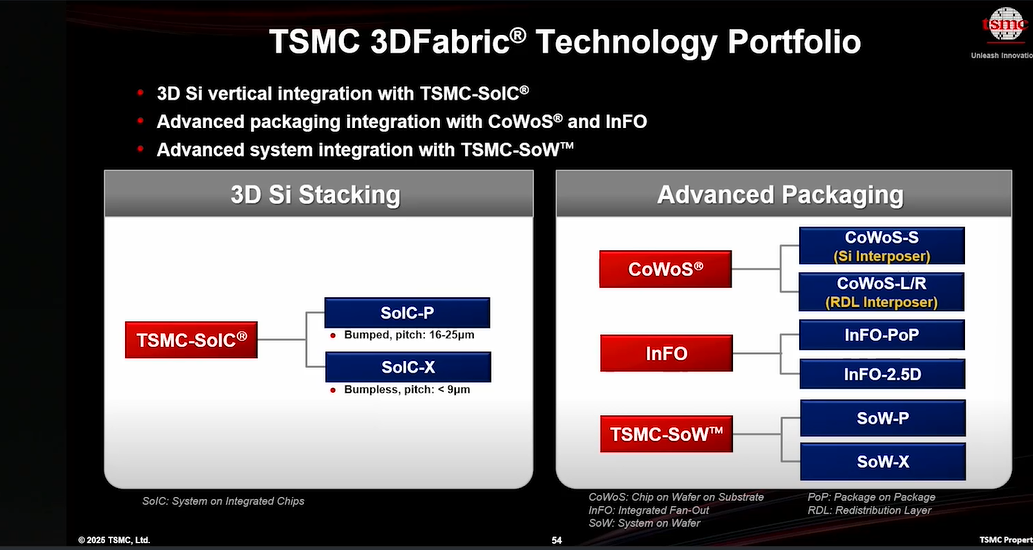
台積電先進封裝技術以3DFabric為核心,包括TSMC-SoIC、CoWoS、InFO、TSMC-SoW四大平台。取自TSMC
提到台積電 SoIC 技術,台積電執行副總經理暨共同營運長米玉傑日前於北美技術論壇指出,此技術已自2022年量產;而用於 N3-on-N4(3奈米晶片堆疊在4奈米晶片上)面朝面堆疊、6μm間距的 SoIC 將於今年投產,實現超高密度互連。台積電將繼續減少鍵合間距,下一代 SoIC 即 A14-on-N2(A14堆疊在2奈米晶片上)則將於2029年準備就緒,比第一代 SoIC 互連技術提升20倍。
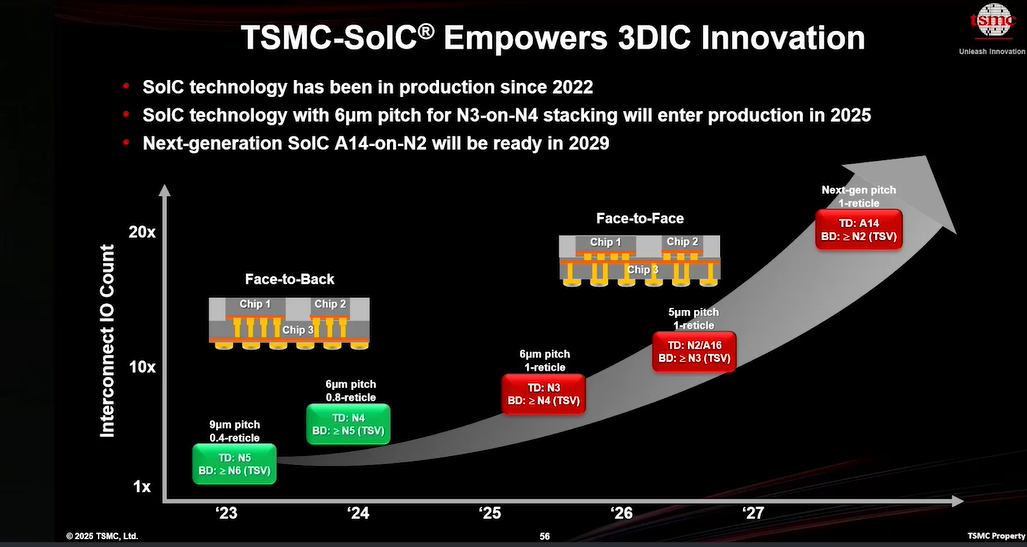
台積電SoIC平台今年將量產N3-on-N4堆疊技術,採用6μm鍵合間距。取自TSMC
CoWoS 技術可將先進的 SoC 或 SoIC 晶片與 HBM高頻寬記憶體進行整合,滿足市場對 AI 晶片的嚴苛要求。CoWoS 平台包括成熟度最高、採用矽中介層的 CoWoS-S,以及採用有機中介層的 CoWoS-L 和 CoWoS-R。
米玉傑指出,CoWoS-S 在2012年量產,至今已超過10年,它可支援3.3倍光罩尺寸的中介層。台積電將持續拓展 CoWoS-L 技術,5.5倍光罩尺寸的 CoWoS-L 將於2026年推出;並計劃在2027年量產9.5倍光罩尺寸的 CoWoS-L 解決方案,採用 A16 製程技術的 SoIC 晶片,將12個或更多 HBM4E 堆疊整合到一個封裝中。
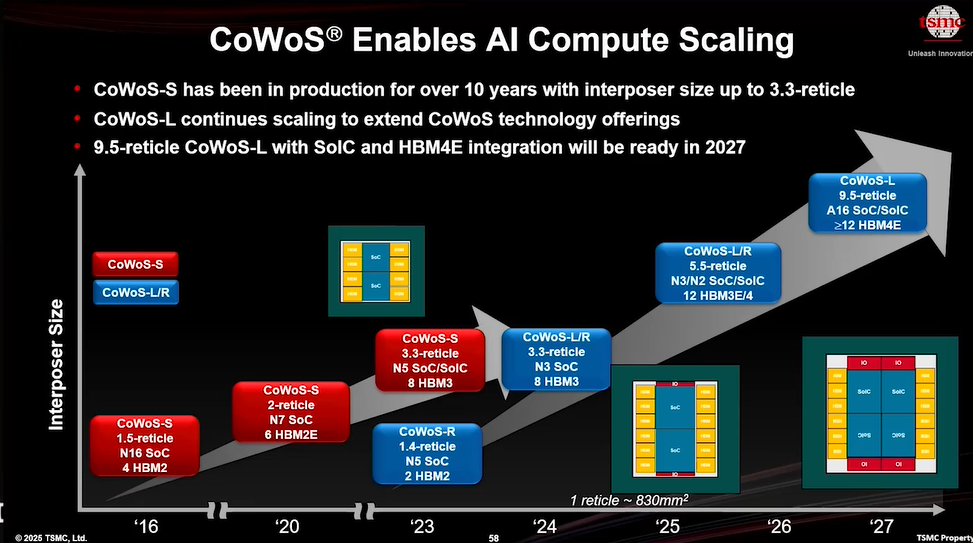
採用9.5倍光罩尺寸的CoWoS-L技術將在2027年量產。取自TSMC
基於 AI 訓練對運算能力需求激增,需要快速擴展邏輯晶片和 HBM記憶體的整合能力,將運算能力提升7倍以上,所以,SoW(System-on-Wafer)系統級晶圓技術應運而生
TSMC-SoW 是台積電最具前瞻性的革命性封裝技術,可支援更大的光罩尺寸,將記憶體或邏輯晶片垂直堆疊在系統晶圓上,藉此滿足下一代 AI 資料中心的需求。
TSMC-SoW 技術包括 SoW-P 和 SoW-X。採用 InFO 技術的「SoW-P」專注邏輯晶片整合,已於2024年量產。今年則發表以 CoWoS 技術為基礎的「SoW-X」,支援邏輯晶片和 HBM記憶體整合,是一個比現有 CoWoS 解決方案高出40倍運算能力的晶圓尺寸系統,計劃於2027年量產。
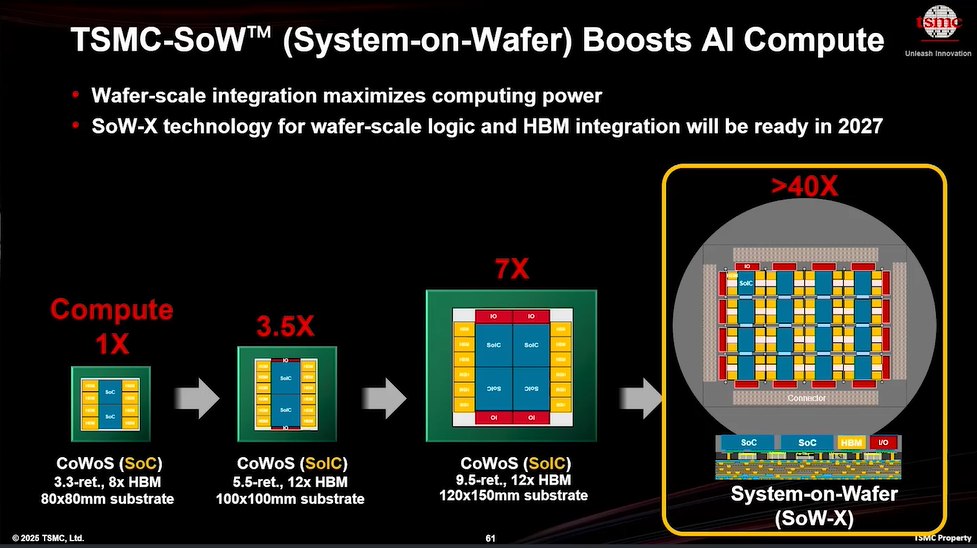
SoW-X系統級晶圓比現有CoWoS高出40倍運算能力,計劃於2027年量產。取自TSMC
台積電資深副總經理暨副共同營運長侯永清在技術論壇提及,今年將增加9座新廠,其中有8座是晶圓廠,1座是先進封裝廠。而在 CoWoS 產能部分,自2022年至2026年,CoWoS 產能年複合成長率將達80%。目前 CoWoS-L 在產量的提升表現比 CoWoS-S 還要好,同時也積極增加 SoIC 產能,到了2026年,SoIC 產能將比2022年提升100%。
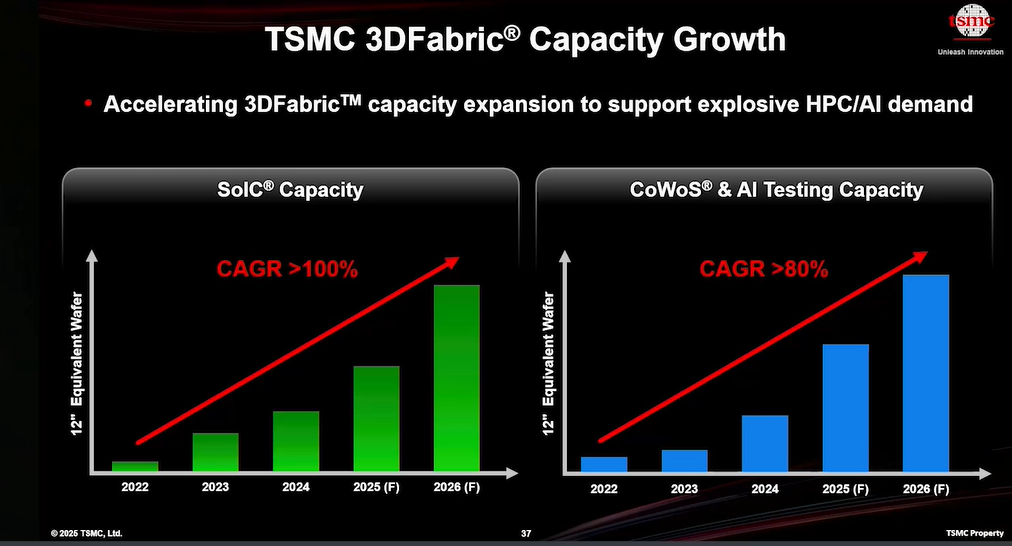
台積電SoIC和CoWoS產能分別以100%、80%年複合成長率大量提升。取自TSMC
2025年,台中先進封測5廠即將開始量產 CoWoS,而龍潭、竹南2座封裝廠也會投入更多資源。而位於嘉義、南科的先進封測7廠、8廠正在如火如荼趕工中,將於今年或明年量產。美國亞利桑那則規劃設立2座先進封裝廠。
至於台積電的競爭對手英特爾近年也積極布局先進封裝。Intel 先進封裝解決方案名為「Foveros」。甫落幕的 Foundry Direct Connect 2025大會上,Intel 宣布 Foveros 新增兩項技術,分別為 Foveros-R 和 Foveros-B,為客戶提供更有效率和彈性的選擇。另推出全新先進封裝技術產品 EMIB-T,可滿足未來高頻寬記憶體需求。
此外,透過 Foveros Direct(3D堆疊)和嵌入式多晶片互連橋接 EMIB(2.5D橋接)技術,將 Intel 14A 製程與 Intel 18A-PT 進行連接,實現系統級整合。
英特爾先進封裝廠位於美國新墨西哥州、奧勒岡州和馬來西亞;新墨西哥廠進行 EMIB 技術開發,該廠甫於4月取得無塵室認證,將於第二季建造完成,未來將提高1.3倍產能。

英特爾先進封裝廠位於美國新墨西哥州、奧勒岡州和馬來西亞,正在急速擴充產能。取自Intel
最新more>
熱門more>
- 張凌赫「唯一交往女友」爆新戀情 白鹿和小6歲男神待同小區!官方認1事
- 心臟移植童點餐註明:不要生菜 摩斯漢堡員工「回覆1紙條」暖爆7萬人
- 離譜!一家人狂打9歲童「母冷眼旁觀」 他忍痛深夜衝超商求救
- 擎天崗「情侶打砲」爆紅掀朝聖!「恐龍野戰」深夜湧5000人線上圍觀
- 【獨家】不讓小玉減刑!鄭家純拖到「他確定入獄」才和解 討犯罪所得結果曝
- 嘉義驚爆國中生遭9同學持鋁棍、水泥塊痛毆逼下跪 法官一原因判「非霸凌」
- 阿信助理「扶正祕辛」又被扒 緋聞對象盤點!唯一公開戀情是她
- 台股崩盤說再起? 謝金河:台積電撐著不會崩盤 呼籲政府快對公務員、醫護調薪
- 轟「鳳梨」吳泓逸12槍 他逃亡10個月曬機票返台歸案!檢方證實1事
- 柯案二審備戰!高院先祭「柯文哲條款」防法官落跑 貪污庭12人請調添變數

